エレクトロニクス事業
配線形成用シードフィルム
配線形成用シードフィルム
第5世代移動通信システム(5G)の普及に伴い、使用周波数帯域であるSub6(無線LANなどでよく使われている6GHz未満の周波数帯域)や、ミリ波帯で高周波信号を遅延なく伝送する銅配線技術が重要になってきています。高周波伝送は、短時間で多くの電気信号を伝送できるメリットがある一方、銅配線の表層に電流が集中する表皮効果が顕著となるため、その表層形状に凹凸があると電気信号の移動距離が長くなり、伝送損失が増大します。
そこで、表面や側面が平滑な銅配線を形成する技術が求められています。従来の配線形成技術では、下図の通りシード層※の銅をエッチングする際に、銅配線が同時に溶解されるため、配線自体が痩せて配線の表面や側面の凹凸が大きくなるという課題がありました。
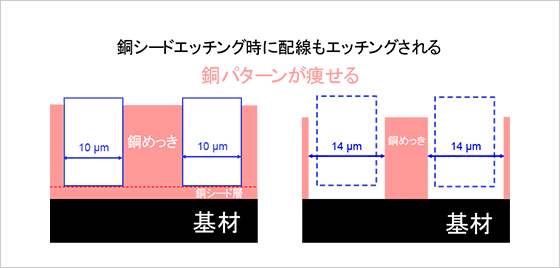
そこで当社は、ナノ金属からなる新シードがコーティングされた「高周波対応配線形成用新シードフィルム」をDIC株式会社と共同開発いたしました。本製品は、銅を溶解させることなくシード金属のエッチングが可能であり、銅配線の痩せ、及び表面の凹凸を抑制することが可能です。
このフィルムのシード層上にパターンを形成し、パターン内を銅めっき処理することで右図のような断面構造の銅配線が形成されます。
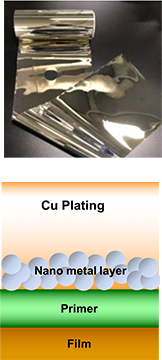
次に、ナノ金属からなる新シード層のみをエッチング可能な専用エッチング液を用いた場合の銅と新シード層の単位時間あたりのエッチング量を左図に示します。
新シード層は僅か数秒でエッチングされる一方、銅は15分間の浸漬処理を経てもエッチングされないことから、新シード層のみを選択的に除去できることが分かります。
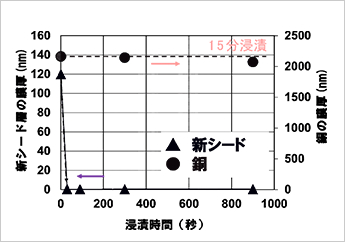
次に、実際の配線断面の形状を、既存プロセスと新シードフィルムで比較しました。
既存プロセスでは、シード層に銅を使用しているため、銅を溶解するエッチング液を使用する必要があり、左下図のようにシード層のエッチング後には、配線が痩せ、線間幅が7µmも広がり断面形状が台形になっていることが分かります。一方、新シードフィルムは、エッチング前後に線間幅の変化はありません。
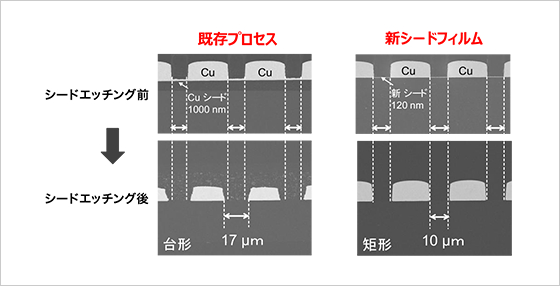
また、左下図からは、既存プロセスではシード層のエッチング後、銅配線の表面の粗さが増大していることが分かります。一方で、右下図の新シードフィルムは銅配線が溶解せず、表面に凹凸がない形状を維持していることが分かります。銅は溶解せずシード層のみが溶解する専用エッチング液を使用することにより、このような凹凸の少ない銅配線が得られます。
本開発品は、ポリイミドフィルムを基材としているため、高周波対応フレキシブルプリント配線板(FPC)への適用が可能です。今後は、ポリイミドフィルム以外のフィルム基材やリジット基材に適用することで、Sub6、ミリ波といった5Gの本格化に向けて必要となる高周波対応配線形成用材料へと展開する計画です。